

FC-CSP基板技术能力
WB-CSP基板技术能力
Memory-eMMC基板技术能力
Memory-MSD基板技术能力
RF基板技术能力
MEMS-SEN基板技术能力
MEMS-MIC基板技术能力
FC-CSP基板技术能力
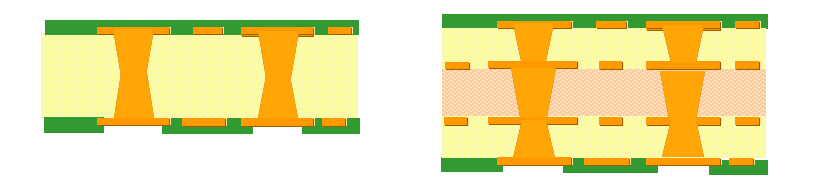
· 层数/layer amount: 2,4,6
· 线宽trace width/线距space:12/12μm,密集线路
· 值球焊垫中心距/Bump pitch:180μm
· 油墨类型/Solder resistor type:干膜型/liquid and dry film type
· 典型表面处理/Typical Surface finish:OSP
· 油墨对准度SM Registration:±20μm
· 支持阻抗设计/Support Impedance
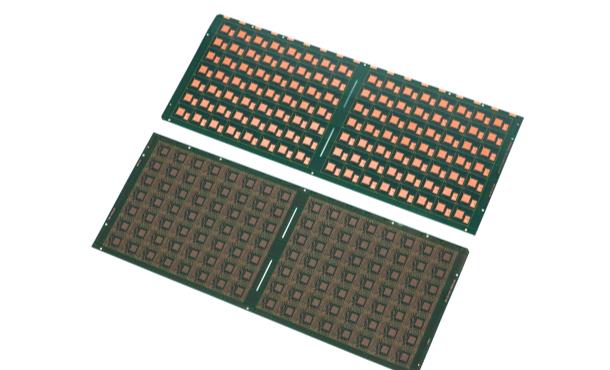
FC-CSP基板
基板特征
· 2~6层板
· 封装方式: FC
· 线宽/线距:12/12μm~25μm/25μm
应用领域
FCCSP基板用于智能手机、平板、多媒体设备等领域高端处理器芯片的封装。
WB-CSP基板技术能力
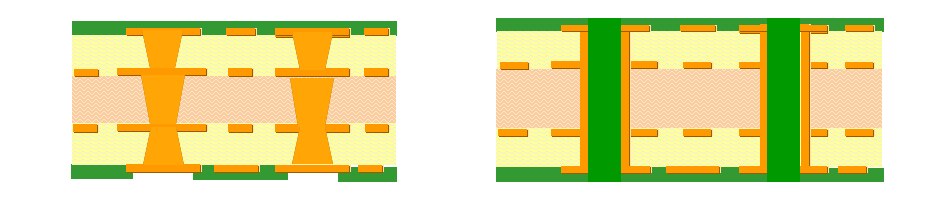
· 层数/layer amount: 2,4,6
· 线宽trace width/线距space:30/30μm,密集线路
· 手指finger width/手指间距finger space:90/40μm
· 油墨类型/Solder resistor type:液态和干膜型/liquid and dry film type
· 严格的油墨平整度要求/ Strict SM flatness control ≤5μm
· 油墨对准度SM Registration:±20μm
· 支持内层厚铜设计/support Inner Layer Cu Thickness 1OZ
· 支持阻抗设计/Support Impedance
· 支持无引线电镀镍金设计/Support Bussless

WB-CSP基板
基板特征
· 2~6层板
· 封装方式: WB
· 尺寸: 3x3mm - 23x23mm
· 板厚: 0.11mm~0.56mm
· 线宽/线距:25/25μm~40μm/40μm
应用领域
手机,平板电脑,机顶盒等用的应用处理器
Memory-eMMC基板技术能力
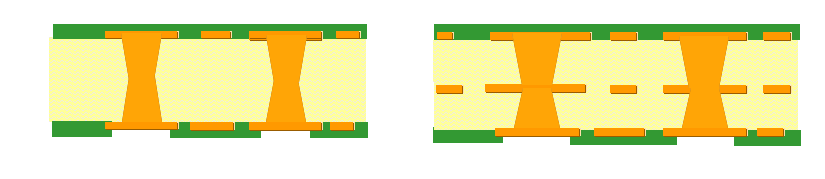
· 层数/layer amount: 2,3,4
· 薄板: 2L 100μm, 3L 130μm, 4L 170μm
· 线宽pitch/width/space:50/18/20μm , 手指 pitch/width/space:70/40/15μm
· 油墨平整度SR Flatness:线路3μm, 孔5μm
· 油墨油墨类型/Solder resistor type:液态和干膜型/liquid and dry film type
· 盲孔孔径BLV/孔盘Land:65/125μm

Memory-eMCP基板
基板特征
· 2,3,4层板/
· 打线手指节距70~90μm
· 严格的油墨平整度控制
表面处理:电金+OSP
应用领域
应用于手机、PC、服务器等设备中的嵌入式存储芯片封装。
Memory-MSD基板技术能力
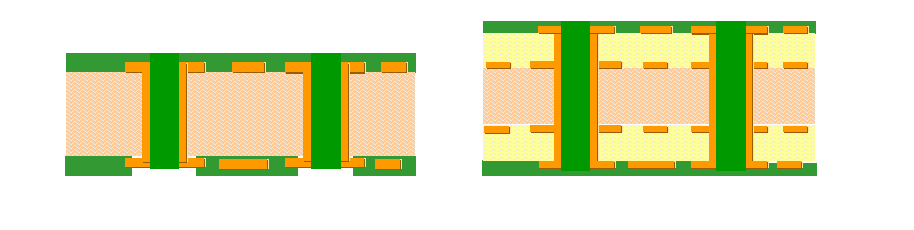
· 层数/layer amount: 2,4
· 板厚: 2L 130μm, 210μm 4L 220μm
· 线宽pitch/width/space:70/20/20μm , 手指 pitch/width/space:90/35/15μm
· 油墨平整度SR Flatness:线路3μm, 孔5μm

Memory-MSD基板
基板特征
· 2~4层板
· 板厚:130μm
· 打线手指节距:75μm~100μm
· 油墨种类:黑油
· 表面处理:电硬金,电镀软金
应用领域
应用于手机,导航,数码相机,PAD, Laptop等设备中的Memory模块。
RF基板技术能力
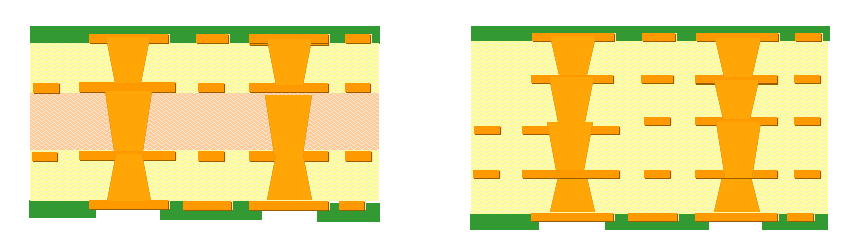
· 层数/layer amount: 2-6
· 线宽公差:减成法:±10μm,改进半加成法: :±5μm /Subtractive Process:±10μm,MSAP: :±5μm
· 表面处理:化学学镍钯金或电镀镍金,支持WB和FC封装/ Surface finish: ENEPIG and Ni&Au,support WB and FC assembly
· 盲孔孔径/孔盘:60/110μm, BLV Dia/Land: 60/110μm
· 相邻层与任意层层间对位能力/Layer shift :Adjacent layer / Any layer:25μm Max/50μm Max
· 支持孔上打线设计,塞孔凹陷-3~+5μm/Support via on finger design,dimple range -3~5μm
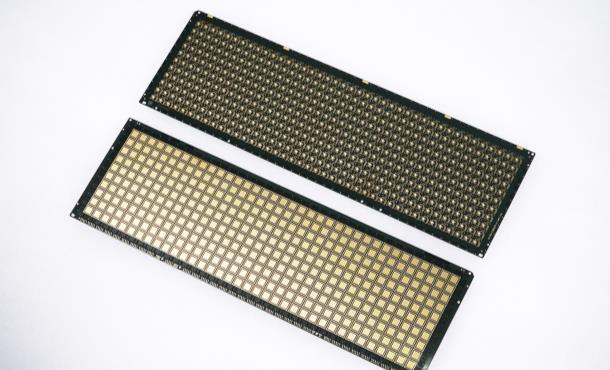
RF基板
基板特征
· 2~8层板
· 表面处理方式: 电镀镍金,无引线电镍金,化学镍钯金,OSP 等
· 严格的图形和厚度一致性管控
· 严格的层间对位管控
应用领域:
应用于手机、可穿戴设备中的RFFEM模块等。
MEMS-SEN基板技术能力
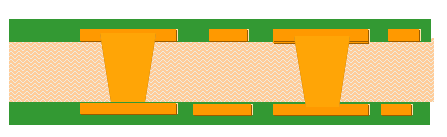
· 2层板板厚/2L Thin board , Total thickness : 100μm ±20μm;
· 线宽trace width/线距space:25/25μm
· 油墨类型/Solder resistor type:液态和干膜型/liquid and dry film type
· 盲孔孔径BLV/孔盘Land:65/125μm
· 油墨对准度SM Registration:±15μm
· 支持无引线电镀镍金设计/Support Bussless
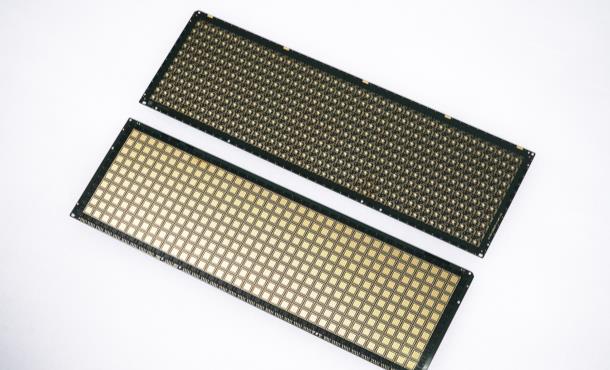
MEMS-SEN基板
基板特征
· 2层板
· 薄板:100μm~130μm
· 精细线路
· 表面处理方式: 电镀镍金,无引线电镍金,化学镍钯金,OSP 等
· 严格的翘曲度控制
应用领域
应用于智能手机、可穿戴设备、汽车、医疗等领域的传感器封装。
MEMS-MIC基板技术能力

· 层数/layer amount: 2,4,6
· 埋电容材料电容密度/nEmbeded capacitance density Max.40nf/in2:
· 容值精度/Capacitor value tolerance: Target±20%
· 埋电阻材料方阻率/Rs for Embeded resistance material:10~250 Ω/□
· 基板阻值精度/Resistor value tolerance: Target±20%
· 结构多样,支持树脂塞孔和铜塞孔/ Multiple structure, support resin and copper plugging
· 声孔孔径公差/ Port Hole Dia Tolerance (NPTH):±50μm

MEMS-MIC基板
基板特征
· 2,4,6层板
· 埋容埋阻技术
应用领域
应用于智能手机、智能音箱、可穿戴和PC等设备中的微机电系统-麦克风模组封装。
FC-CSP基板技术能力
WB-CSP基板技术能力
Memory-eMMC基板技术能力
Memory-MSD基板技术能力
RF基板技术能力
MEMS-SEN基板技术能力
MEMS-MIC基板技术能力
FC-CSP基板技术能力
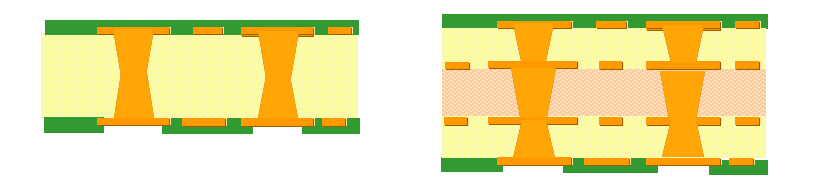
· 层数/layer amount: 2,4,6
· 线宽trace width/线距space:12/12μm,密集线路
· 值球焊垫中心距/Bump pitch:180μm
· 油墨类型/Solder resistor type:干膜型/liquid and dry film type
· 典型表面处理/Typical Surface finish:OSP
· 油墨对准度SM Registration:±20μm
· 支持阻抗设计/Support Impedance
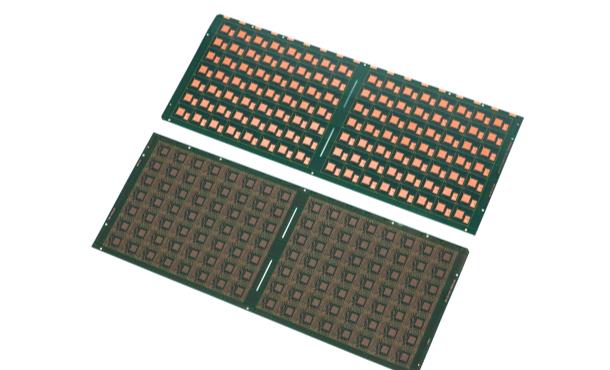
FC-CSP基板
基板特征
· 2~6层板
· 封装方式: FC
· 线宽/线距:12/12μm~25μm/25μm
应用领域
FCCSP基板用于智能手机、平板、多媒体设备等领域高端处理器芯片的封装。
WB-CSP基板技术能力
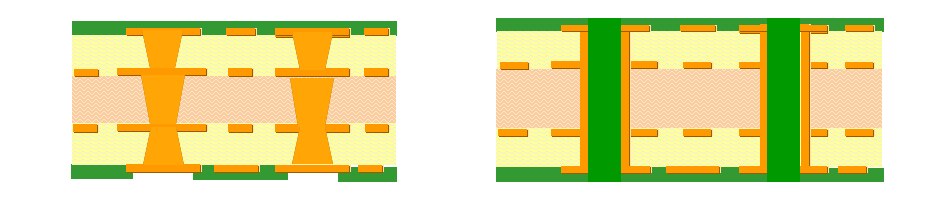
· 层数/layer amount: 2,4,6
· 线宽trace width/线距space:30/30μm,密集线路
· 手指finger width/手指间距finger space:90/40μm
· 油墨类型/Solder resistor type:液态和干膜型/liquid and dry film type
· 严格的油墨平整度要求/ Strict SM flatness control ≤5μm
· 油墨对准度SM Registration:±20μm
· 支持内层厚铜设计/support Inner Layer Cu Thickness 1OZ
· 支持阻抗设计/Support Impedance
· 支持无引线电镀镍金设计/Support Bussless

WB-CSP基板
基板特征
· 2~6层板
· 封装方式: WB
· 尺寸: 3x3mm - 23x23mm
· 板厚: 0.11mm~0.56mm
· 线宽/线距:25/25μm~40μm/40μm
应用领域
手机,平板电脑,机顶盒等用的应用处理器
Memory-eMMC基板技术能力
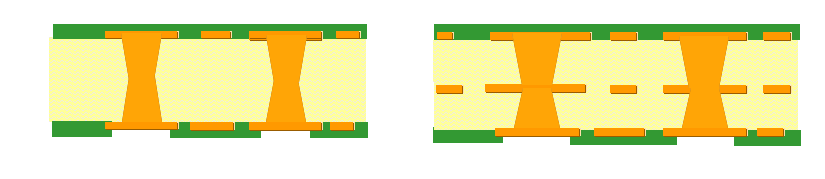
· 层数/layer amount: 2,3,4
· 薄板: 2L 100μm, 3L 130μm, 4L 170μm
· 线宽pitch/width/space:50/18/20μm , 手指 pitch/width/space:70/40/15μm
· 油墨平整度SR Flatness:线路3μm, 孔5μm
· 油墨油墨类型/Solder resistor type:液态和干膜型/liquid and dry film type
· 盲孔孔径BLV/孔盘Land:65/125μm

Memory-eMCP基板
基板特征
· 2,3,4层板/
· 打线手指节距70~90μm
· 严格的油墨平整度控制
表面处理:电金+OSP
应用领域
应用于手机、PC、服务器等设备中的嵌入式存储芯片封装。
Memory-MSD基板技术能力
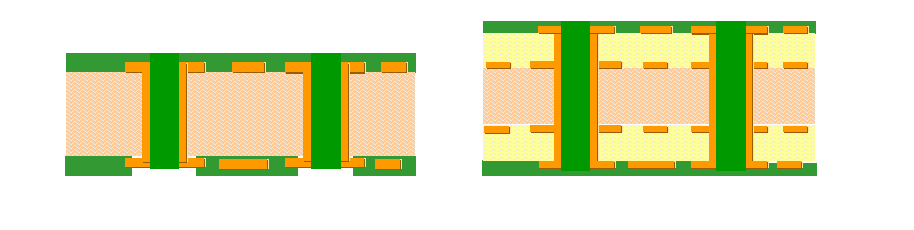
· 层数/layer amount: 2,4
· 板厚: 2L 130μm, 210μm 4L 220μm
· 线宽pitch/width/space:70/20/20μm , 手指 pitch/width/space:90/35/15μm
· 油墨平整度SR Flatness:线路3μm, 孔5μm

Memory-MSD基板
基板特征
· 2~4层板
· 板厚:130μm
· 打线手指节距:75μm~100μm
· 油墨种类:黑油
· 表面处理:电硬金,电镀软金
应用领域
应用于手机,导航,数码相机,PAD, Laptop等设备中的Memory模块。
RF基板技术能力
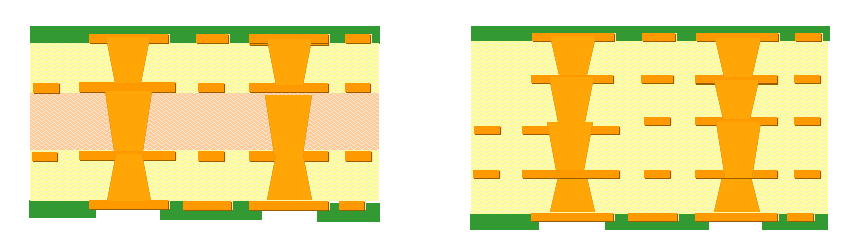
· 层数/layer amount: 2-6
· 线宽公差:减成法:±10μm,改进半加成法: :±5μm /Subtractive Process:±10μm,MSAP: :±5μm
· 表面处理:化学学镍钯金或电镀镍金,支持WB和FC封装/ Surface finish: ENEPIG and Ni&Au,support WB and FC assembly
· 盲孔孔径/孔盘:60/110μm, BLV Dia/Land: 60/110μm
· 相邻层与任意层层间对位能力/Layer shift :Adjacent layer / Any layer:25μm Max/50μm Max
· 支持孔上打线设计,塞孔凹陷-3~+5μm/Support via on finger design,dimple range -3~5μm
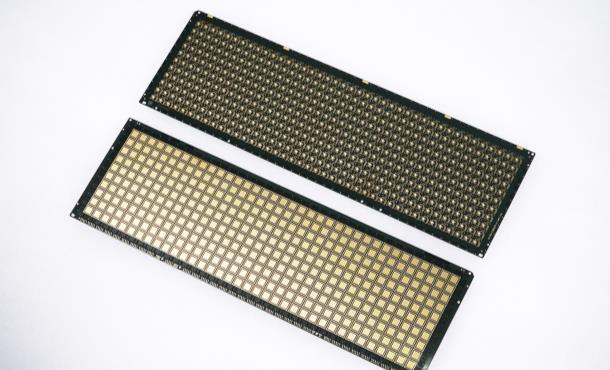
RF基板
基板特征
· 2~8层板
· 表面处理方式: 电镀镍金,无引线电镍金,化学镍钯金,OSP 等
· 严格的图形和厚度一致性管控
· 严格的层间对位管控
应用领域:
应用于手机、可穿戴设备中的RFFEM模块等。
MEMS-SEN基板技术能力
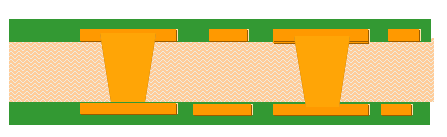
· 2层板板厚/2L Thin board , Total thickness : 100μm ±20μm;
· 线宽trace width/线距space:25/25μm
· 油墨类型/Solder resistor type:液态和干膜型/liquid and dry film type
· 盲孔孔径BLV/孔盘Land:65/125μm
· 油墨对准度SM Registration:±15μm
· 支持无引线电镀镍金设计/Support Bussless
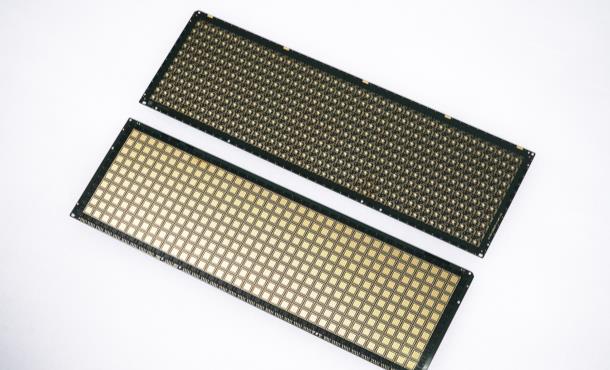
MEMS-SEN基板
基板特征
· 2层板
· 薄板:100μm~130μm
· 精细线路
· 表面处理方式: 电镀镍金,无引线电镍金,化学镍钯金,OSP 等
· 严格的翘曲度控制
应用领域
应用于智能手机、可穿戴设备、汽车、医疗等领域的传感器封装。
MEMS-MIC基板技术能力

· 层数/layer amount: 2,4,6
· 埋电容材料电容密度/nEmbeded capacitance density Max.40nf/in2:
· 容值精度/Capacitor value tolerance: Target±20%
· 埋电阻材料方阻率/Rs for Embeded resistance material:10~250 Ω/□
· 基板阻值精度/Resistor value tolerance: Target±20%
· 结构多样,支持树脂塞孔和铜塞孔/ Multiple structure, support resin and copper plugging
· 声孔孔径公差/ Port Hole Dia Tolerance (NPTH):±50μm

MEMS-MIC基板
基板特征
· 2,4,6层板
· 埋容埋阻技术
应用领域
应用于智能手机、智能音箱、可穿戴和PC等设备中的微机电系统-麦克风模组封装。